碳化硅(SiC)作为典型的宽禁带半导体材料,相较于硅(Si)具有更高的击穿电场强度、更高的导热率、更高的饱和电子漂移速率以及更低的本征载流子浓度等优越的物理性能。这些特性使其在大功率、高温和高频环境下表现出色,因此被广泛应用于新一代功率半导体器件中。与硅基器件相比,SiC基功率半导体器件具有更快的开关速度、更低的损耗、更高的阻断电压和更强的耐高温能力。然而,SiC功率半导体器件尚未得到全面应用,主要原因是成本高和产量低等问题。一个严重的问题是SiC外延材料的缺陷。目前商用的SiC外延材料产品仍存在多种缺陷
原理:在捕获缺陷的光致发光(PL)图像并将其转换为数字格式的过程中,首先用能量远大于4H-SiC晶体禁带宽度的激发光照射SiC同质外延片。所得到的光致发光(PL)被光学系统收集并记录为包含缺陷的晶片特定区域的光致发光(PL)图像。光致发光(PL)通过光学图像传感器(如CCD图像传感器)进行检测,通常使用光学滤光器获取PL图像,滤光器透过特定波段范围的PL光,以适应每种缺陷类型的检测需求。
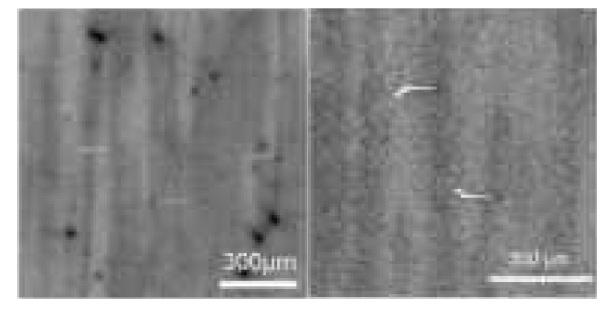
获得的光致发光(PL)图像(数字图像)经过灰度处理,然后通过特定的图像分析,将图像信息简化为描述检测到的缺陷的一组值。灰度图像由晶片中缺陷的初始数字图像产生,这些图像可以转换为二进制图像(阈值处理),从而测量缺陷的大小和形状,同时计算特定区域内缺陷的分布和数量。
推荐产品:
Photon1K相机具备9.7um大像元,0.3e读出噪声,超过100dB动态范围,可以用于捕获光致发光弱信号
另外,在在高灵敏度的基础上,通过减小曝光时间,可以提升光致发光图像采集数量,有效地提升检测效率


